
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe en la fabricación de chips: un informe de noticias profesional
La evolución de los materiales semiconductores
En el ámbito de la tecnología moderna de semiconductores, el incesante impulso hacia la miniaturización ha superado los límites de los materiales tradicionales basados en silicio. Para satisfacer las demandas de alto rendimiento y bajo consumo de energía, SiGe (Silicon Germanium) se ha convertido en el material compuesto preferido en la fabricación de chips semiconductores debido a sus propiedades físicas y eléctricas únicas. Este artículo profundiza en laproceso de epitaxiade SiGe y su papel en el crecimiento epitaxial, aplicaciones de silicio tensado y estructuras Gate-All-Around (GAA).
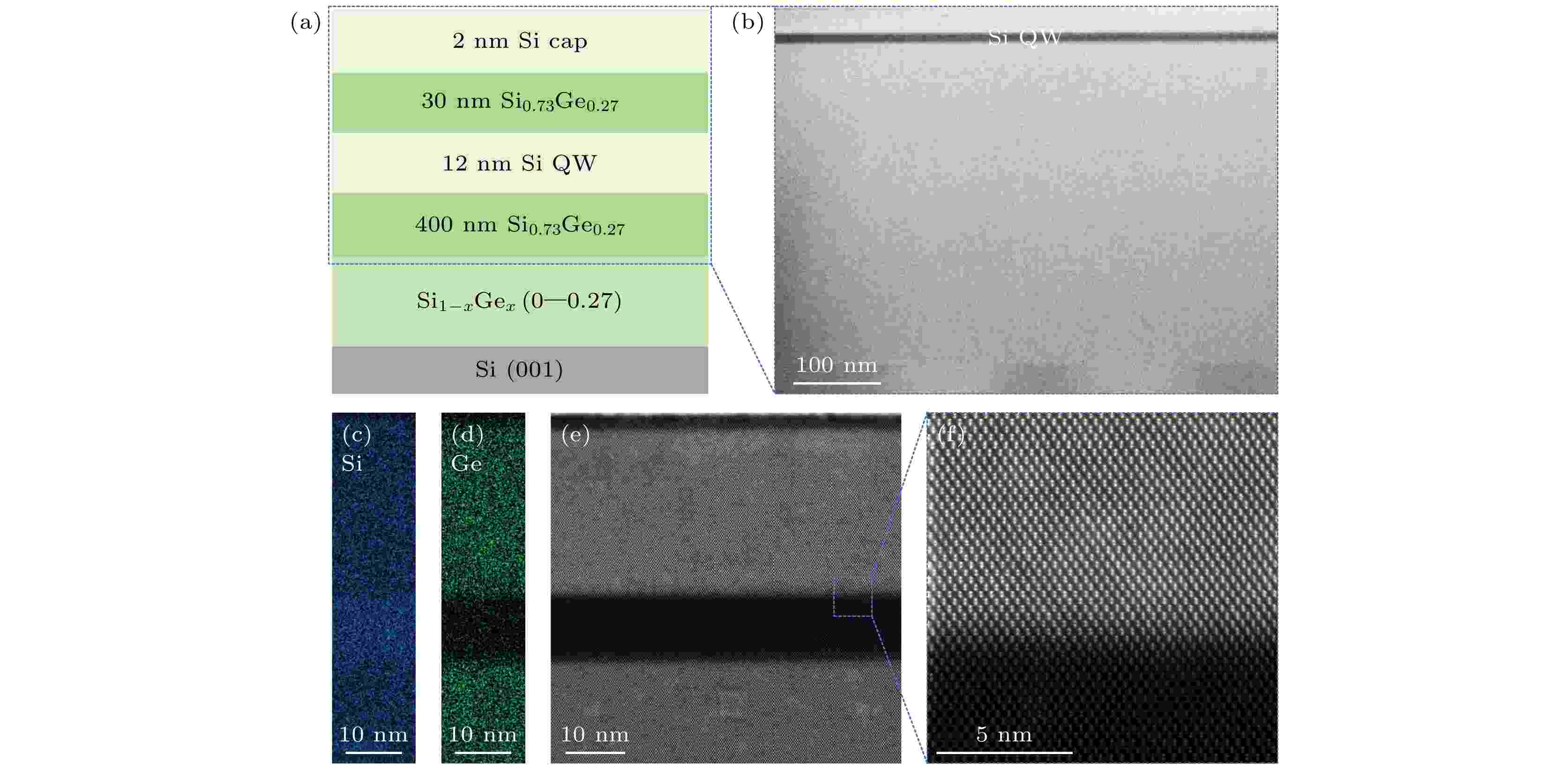
La importancia de la epitaxia de SiGe
1.1 Introducción a la epitaxia en la fabricación de chips:
La epitaxia, a menudo abreviada como Epi, se refiere al crecimiento de una capa monocristalina sobre un sustrato monocristalino con la misma disposición reticular. Esta capa puede serhomoepitaxial (como Si/Si)o heteroepitaxial (tal como SiGe/Si o SiC/Si). Se emplean varios métodos para el crecimiento epitaxial, incluida la epitaxia por haz molecular (MBE), la deposición química de vapor en vacío ultraalto (UHV/CVD), la epitaxia atmosférica y de presión reducida (ATM y RP Epi). Este artículo se centra en los procesos de epitaxia del silicio (Si) y el silicio-germanio (SiGe) ampliamente utilizados en la producción de circuitos integrados de semiconductores con silicio como material sustrato.
1.2 Ventajas de la epitaxia SiGe:
Incorporando una determinada proporción de germanio (Ge) durante laproceso de epitaxiaforma una capa monocristalina de SiGe que no solo reduce el ancho de banda prohibida sino que también aumenta la frecuencia de corte del transistor (fT). Esto lo hace ampliamente aplicable en dispositivos de alta frecuencia para comunicaciones inalámbricas y ópticas. Además, en los procesos avanzados de circuitos integrados CMOS, la falta de coincidencia de la red (alrededor del 4%) entre Ge y Si introduce tensión en la red, mejorando la movilidad de los electrones o huecos y aumentando así la corriente de saturación y la velocidad de respuesta del dispositivo.
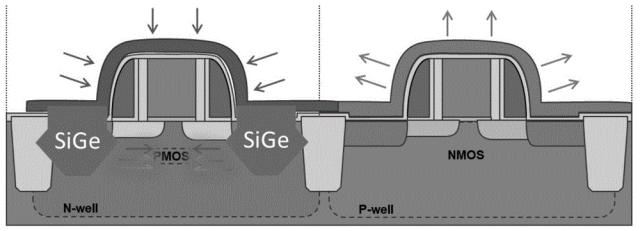
El flujo integral del proceso de epitaxia de SiGe
2.1 Pretratamiento:
Las obleas de silicio se tratan previamente en función de los resultados deseados del proceso, que implican principalmente la eliminación de la capa de óxido natural y las impurezas de la superficie de la oblea. Para obleas de sustrato fuertemente dopadas, es crucial considerar si el sellado posterior es necesario para reducir el autodopaje durante las posteriores.crecimiento de epitaxia.
2.2 Gases de crecimiento y condiciones:
Gases de silicio: el silano (SiH₄), el diclorosilano (DCS, SiH₂Cl₂) y el triclorosilano (TCS, SiHCl₃) son las tres fuentes de gas de silicio más utilizadas. SiH₄ es adecuado para procesos de epitaxia completa a baja temperatura, mientras que TCS, conocido por su rápida tasa de crecimiento, se usa ampliamente para la preparación de espesas.epitaxia de siliciocapas.
Gas de germanio: El germanio (GeH₄) es la fuente principal para agregar germanio y se utiliza junto con fuentes de silicio para formar aleaciones de SiGe.
Epitaxia selectiva: el crecimiento selectivo se logra ajustando las tasas relativas dedeposición epitaxialy grabado in situ, utilizando DCS gas silicio que contiene cloro. La selectividad se debe a que la adsorción de átomos de Cl en la superficie del silicio es menor que en los óxidos o nitruros, lo que facilita el crecimiento epitaxial. El SiH₄, que carece de átomos de Cl y tiene baja energía de activación, generalmente se aplica sólo a procesos de epitaxia completa a baja temperatura. Otra fuente de silicio comúnmente utilizada, el TCS, tiene una presión de vapor baja y es líquida a temperatura ambiente, lo que requiere burbujear H₂ para introducirlo en la cámara de reacción. Sin embargo, es relativamente económico y se utiliza a menudo por su rápida tasa de crecimiento (hasta 5 μm/min) para hacer crecer capas de epitaxia de silicio más gruesas, ampliamente aplicadas en la producción de obleas de epitaxia de silicio.
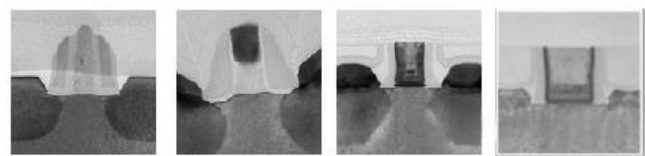
Silicio tenso en capas epitaxiales
Durantecrecimiento epitaxial, el Si monocristalino epitaxial se deposita sobre una capa de SiGe relajada. Debido al desajuste de la red entre Si y SiGe, la capa monocristalina de Si está sujeta a tensión de tracción de la capa de SiGe subyacente, lo que mejora significativamente la movilidad de los electrones en los transistores NMOS. Esta tecnología no sólo aumenta la corriente de saturación (Idsat) sino que también mejora la velocidad de respuesta del dispositivo. Para los dispositivos PMOS, las capas de SiGe se cultivan epitaxialmente en las regiones de fuente y drenaje después del grabado para introducir tensión de compresión en el canal, mejorando la movilidad del orificio y aumentando la corriente de saturación.
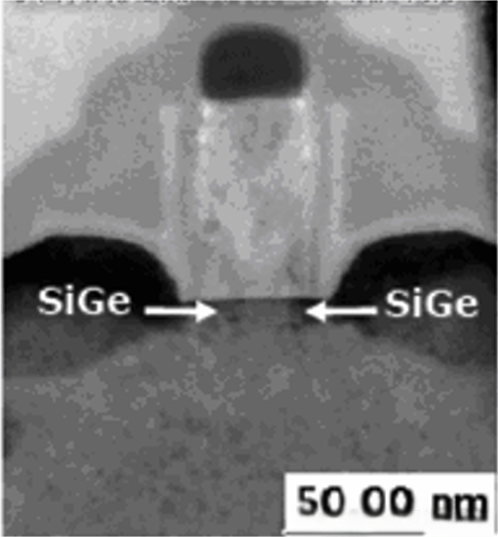
SiGe como capa de sacrificio en estructuras GAA
En la fabricación de transistores de nanocables Gate-All-Around (GAA), las capas de SiGe actúan como capas de sacrificio. Las técnicas de grabado anisotrópico de alta selectividad, como el grabado de capas cuasi atómicas (cuasi-ALE), permiten la eliminación precisa de capas de SiGe para formar estructuras de nanocables o nanoláminas.
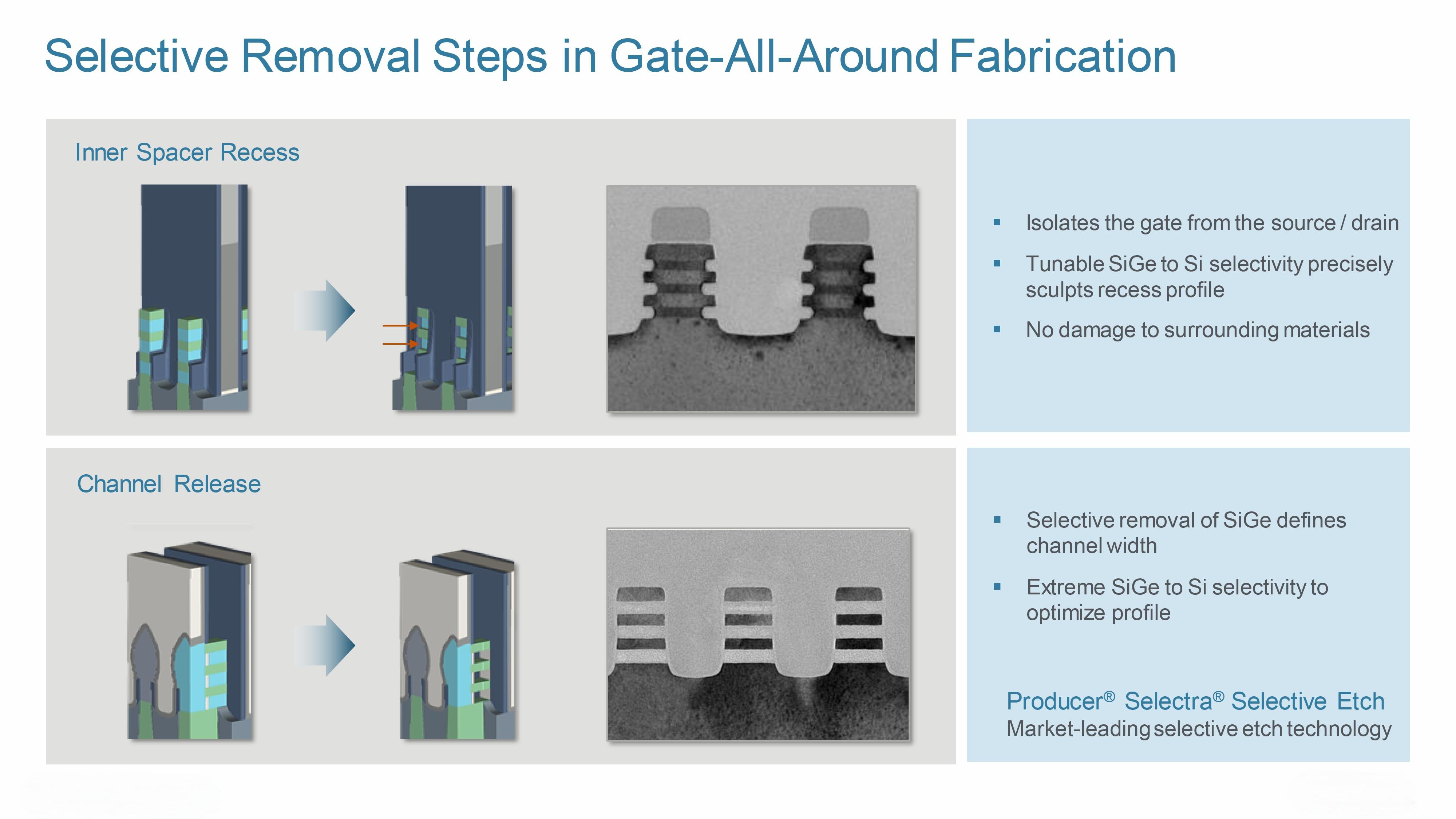
En Semicorex nos especializamos enSoluciones de grafito recubiertas de SiC/TaCaplicado en el crecimiento epitaxial del Si en la fabricación de semiconductores. Si tiene alguna consulta o necesita detalles adicionales, no dude en ponerse en contacto con nosotros.
Teléfono de contacto: +86-13567891907
Correo electrónico: sales@semicorex.com




